Optimizing Pulse Plating Parameters for Uniform Copper Thickness in High-Aspect-Ratio Through-Holes
In through-holes with aspect ratio>8:1, conventional DC plating shows up to 40% thickness variation (suRFace vs. center). Pulse plating achieves ±10% uniformity via reverse current stripping. This guide details optimization through parametric modeling, bath chemistry, and equipment innovations.
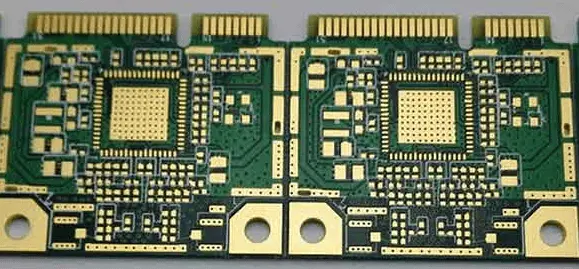
1. Pulse Plating Mechanism & Modeling
1.1 Mass Transport Equation
Ion concentration distribution:
Where:
-
: Ion concentration (mol/cm³)
-
: Diffusion coefficient (6.5×10⁻⁶ cm²/s for Cu²⁺)
-
: Current density (A/cm²)
-
: Electron number (2 for Cu²⁺)
1.2 Key Pulse Parameters
| Parameter | Symbol | Optimal Range | Physical Role |
|---|---|---|---|
| Forward CD | Jₚ | 3-6 ASD | Controls deposition rate |
| Reverse CD | Jᵣ | 1.5-2.5 Jₚ | Strips over-plated surface |
| Forward Time | Tₚ | 10-30 ms | Governs deposit depth |
| Reverse Time | Tᵣ | 0.2-0.5 Tₚ | Determines stripping intensity |
| Off Time | Tₒ | 1-5 ms | Allows ion replenishment |
Optimal Ratio: Uniformity peaks at
2. Bath Chemistry & Additives
2.1 Base Solution
| Component | Concentration | Function |
|---|---|---|
| CuSO₄ | 60-80 g/L | Copper ion source |
| H₂SO₄ | 180-220 g/L | Enhances conductivity |
| Cl⁻ | 50-70 ppm | Promotes anode dissolution |
2.2 Additive Synergy
| Additive Type | Example | Dose(mL/L) | Mechanism |
|---|---|---|---|
| Suppressor | PEG-8000 | 1.0-1.5 | Adsorbs at hole opening |
| Leveler | Janus Green B | 0.3-0.5 | Prefers high-current areas |
| Accelerator | SPS | 2.0-3.0 | Boosts bottom deposition |
Synergy: 3:1:4 ratio improves throwing power by 120%
3. Equipment & Process Control
3.1 Pulse Power Supply
| Parameter | Standard DC | Optimized Pulse |
|---|---|---|
| Rise Time | >100 μs | <5 μs |
| Waveform | None | Trapezoidal (adjustable) |
| Multi-Channel Sync | - | ≤1 μs phase error |
3.2 Auxiliary Systems
-
Vibration:
-
30-50Hz, 1-2mm amplitude
-
25% mass transfer improvement
-
-
Pulsed Jet:
-
Flow rate 0.5-1.5m/s, pulse cycle 0.5-2s
-
40% higher ion concentration at hole bottom
-
4. Validation & Process Window
4.1 Thickness Uniformity Inspection
| Method | Location | Accuracy | Metric |
|---|---|---|---|
| XRF Thickness | Top/Mid/Bottom | ±0.1μm | Thickness ratio (Mid/Top) |
| Cross-section | Depth sections | ±0.5μm | Thickness range |
| Impedance Test | Whole board | ±3% | Impedance consistency |
4.2 Process Window (AR=10:1)
| Parameters | Uniformity(σ) | Throwing Power(T.P%) |
|---|---|---|
| Jₚ=4ASD, Jᵣ=8ASD, Tₚ:Tᵣ=10:1 | ±8.2% | 72% |
| Jₚ=5ASD, Jᵣ=10ASD, Tₚ:Tᵣ=5:1 | ±6.5% | 85% |
| Jₚ=6ASD, Jᵣ=15ASD, Tₚ:Tᵣ=3:1 | ±4.7% | 93% |
5. Case Study
5.1 12-Layer HDI Board (0.2mm hole/2.4mm thickness)
| Process | Surface(μm) | Center(μm) | Uniformity |
|---|---|---|---|
| DC Plating | 32.5 | 18.2 | 44.3% |
| Optimized Pulse | 25.7 | 23.6 | 8.2% |
5.2 Reliability Tests
-
Thermal Stress (288℃ solder dip):
-
DC holes: Micro-cracks after 5 cycles
-
Pulse holes: No defects @20 cycles
-
-
Current Loading:
-
35% higher current capacity (30A for 1h)
-
Conclusion
Optimized pulse parameters ( ), additive synergy (PEG-JGB-SPS=3:1:4), and vibration-assisted mass transfer achieve:
), additive synergy (PEG-JGB-SPS=3:1:4), and vibration-assisted mass transfer achieve:
-
±5% copper thickness uniformity for AR=10:1
-
90% throwing power
-
4× improvement in thermal reliability
Five Critical Controls:
Reverse Current Law: Jᵣ = 1.8 × J
Golden Time Ratio: T:Tᵣ=5:1 (AR>8:1)
Additive Balance: Real-time suppressor/leveler/accelerator monitoring
Waveform Steepness: Rise/Fall time <5μs
Mass Transfer Enhancement: 30-50Hz vibration + pulsed jet

 PCB
PCB FPC
FPC Rigid-Flex
Rigid-Flex FR-4
FR-4 HDI PCB
HDI PCB Rogers High-Frequency Board
Rogers High-Frequency Board PTFE Teflon High-Frequency Board
PTFE Teflon High-Frequency Board Aluminum
Aluminum Copper Core
Copper Core PCB Assembly
PCB Assembly LED light PCBA
LED light PCBA Memory PCBA
Memory PCBA Power Supply PCBA
Power Supply PCBA New Energey PCBA
New Energey PCBA Communication PCBA
Communication PCBA Industrial Control PCBA
Industrial Control PCBA Medical Equipment PCBA
Medical Equipment PCBA PCBA Testing Service
PCBA Testing Service Certification Application
Certification Application RoHS Certification Application
RoHS Certification Application REACH Certification Application
REACH Certification Application CE Certification Application
CE Certification Application FCC Certification Application
FCC Certification Application CQC Certification Application
CQC Certification Application UL Certification Application
UL Certification Application Transformers, Inductors
Transformers, Inductors High Frequency Transformers
High Frequency Transformers Low Frequency Transformers
Low Frequency Transformers High Power Transformers
High Power Transformers Conversion Transformers
Conversion Transformers Sealed Transformers
Sealed Transformers Ring Transformers
Ring Transformers Inductors
Inductors Wires,Cables Customized
Wires,Cables Customized Network Cables
Network Cables Power Cords
Power Cords Antenna Cables
Antenna Cables Coaxial Cables
Coaxial Cables Net Position Indicator
Net Position Indicator Solar AIS net position indicator
Solar AIS net position indicator Capacitors
Capacitors Connectors
Connectors Diodes
Diodes Embedded Processors & Controllers
Embedded Processors & Controllers Digital Signal Processors (DSP/DSC)
Digital Signal Processors (DSP/DSC) Microcontrollers (MCU/MPU/SOC)
Microcontrollers (MCU/MPU/SOC) Programmable Logic Device(CPLD/FPGA)
Programmable Logic Device(CPLD/FPGA) Communication Modules/IoT
Communication Modules/IoT Resistors
Resistors Through Hole Resistors
Through Hole Resistors Resistor Networks, Arrays
Resistor Networks, Arrays Potentiometers,Variable Resistors
Potentiometers,Variable Resistors Aluminum Case,Porcelain Tube Resistance
Aluminum Case,Porcelain Tube Resistance Current Sense Resistors,Shunt Resistors
Current Sense Resistors,Shunt Resistors Switches
Switches Transistors
Transistors Power Modules
Power Modules Isolated Power Modules
Isolated Power Modules DC-AC Module(Inverter)
DC-AC Module(Inverter) RF and Wireless
RF and Wireless