Evaluating Crystallographic Quality of Blind Via Bottom Copper Layers via Metallographic Cross-Section Analysis
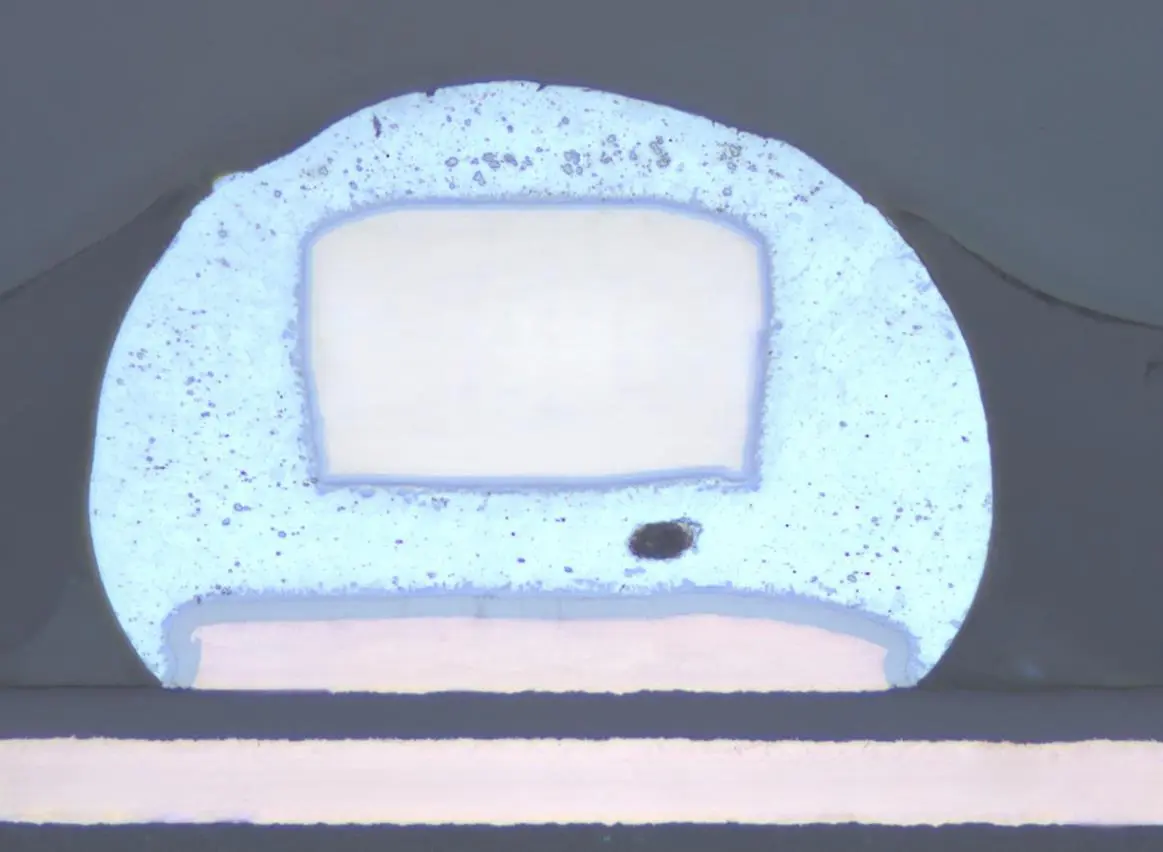
In Hdi Pcb manufacturing, the crystallographIC quality of blind via bottom copper layers critically impacts interconnection reliability. Coarse grains or abnormal textures accelerate electromigration and reduce mechanical strength. Metallographic cross-section analysis combined with microscopy enables quantitative evaluation of grain size, orientation, and defects.
1. Sample Preparation
1.1 Sectioning and Mounting
-
Precision cutting: Diamond wire saw aligned perpendicular to via axis (≤5μm error, Figure 1);
-
Cold mounting: Low-shrinkage epoxy (e.g., EpoFix™) under vacuum, cured at 25℃×24h.
1.2 Grinding and Polishing
-
Coarse grinding: SiC paper (#320→#1200) with water cooling;
-
Fine polishing:
-
Initial: 3μm diamond suspension, 150rpm×5min;
-
Final: 0.05μm silica colloid, 100rpm×2min (Ra<0.01μm).
-
2. Microstructure Visualization
2.1 Chemical Etching
-
Etchant: Fe(NO₃)₃ (10g) + ethanol (100ml) + H₂O (50ml);
-
Conditions: 15-30s immersion at 25℃ (gray-level contrast >30%, Figure 2).
2.2 EBSD Analysis
-
Sample preparation: Ion polishing (5kV×2h) to remove damage;
-
Scanning: 0.1μm step size, 20kV, IPF-Z mapping.
3. Crystallographic Metrics
3.1 Grain Size Measurement
-
Line-intercept method: Draw 5 random lines (total 500μm), calculate average grain size:
where L=total length, N=intersections, M=magnification.
3.2 Texture Coefficient
-
ODF analysis: Calculate pole densities for (111)/(200) planes:
TC>3 indicates strong anisotropy.
3.3 Defect Quantification
-
Porosity: ImageJ analysis of dark area ratio (<0.5% required);
-
Twin density: Annealing twins counted per mm² (normal range:50-200/mm²).
4. Case Study
Server motherboard blind via analysis:
-
Grain size: 8.2μm (plated at 2ASD, additive A=5ml/L);
-
Texture: TC(111)=2.1, TC(200)=1.3 (weak texture);
-
Porosity: 0.12%;
-
Reliability: <2% resistance change after 1000 thermal cycles (-55℃~125℃).
Conclusion
Metallographic cross-section analysis with quantitative imaging provides precise evaluation of copper layer crystallography, guiding plating process optimization to ensure long-term reliability in high-density interconnects.

 PCB
PCB FPC
FPC Rigid-Flex
Rigid-Flex FR-4
FR-4 HDI PCB
HDI PCB Rogers High-Frequency Board
Rogers High-Frequency Board PTFE Teflon High-Frequency Board
PTFE Teflon High-Frequency Board Aluminum
Aluminum Copper Core
Copper Core PCB Assembly
PCB Assembly LED light PCBA
LED light PCBA Memory PCBA
Memory PCBA Power Supply PCBA
Power Supply PCBA New Energey PCBA
New Energey PCBA Communication PCBA
Communication PCBA Industrial Control PCBA
Industrial Control PCBA Medical Equipment PCBA
Medical Equipment PCBA PCBA Testing Service
PCBA Testing Service Certification Application
Certification Application RoHS Certification Application
RoHS Certification Application REACH Certification Application
REACH Certification Application CE Certification Application
CE Certification Application FCC Certification Application
FCC Certification Application CQC Certification Application
CQC Certification Application UL Certification Application
UL Certification Application Transformers, Inductors
Transformers, Inductors High Frequency Transformers
High Frequency Transformers Low Frequency Transformers
Low Frequency Transformers High Power Transformers
High Power Transformers Conversion Transformers
Conversion Transformers Sealed Transformers
Sealed Transformers Ring Transformers
Ring Transformers Inductors
Inductors Wires,Cables Customized
Wires,Cables Customized Network Cables
Network Cables Power Cords
Power Cords Antenna Cables
Antenna Cables Coaxial Cables
Coaxial Cables Net Position Indicator
Net Position Indicator Solar AIS net position indicator
Solar AIS net position indicator Capacitors
Capacitors Connectors
Connectors Diodes
Diodes Embedded Processors & Controllers
Embedded Processors & Controllers Digital Signal Processors (DSP/DSC)
Digital Signal Processors (DSP/DSC) Microcontrollers (MCU/MPU/SOC)
Microcontrollers (MCU/MPU/SOC) Programmable Logic Device(CPLD/FPGA)
Programmable Logic Device(CPLD/FPGA) Communication Modules/IoT
Communication Modules/IoT Resistors
Resistors Through Hole Resistors
Through Hole Resistors Resistor Networks, Arrays
Resistor Networks, Arrays Potentiometers,Variable Resistors
Potentiometers,Variable Resistors Aluminum Case,Porcelain Tube Resistance
Aluminum Case,Porcelain Tube Resistance Current Sense Resistors,Shunt Resistors
Current Sense Resistors,Shunt Resistors Switches
Switches Transistors
Transistors Power Modules
Power Modules Isolated Power Modules
Isolated Power Modules DC-AC Module(Inverter)
DC-AC Module(Inverter) RF and Wireless
RF and Wireless
