Key Technologies for Interlayer Alignment Accuracy Control in Blind/Buried Via PCBs
Key Technologies for Interlayer Alignment Accuracy Control in Blind/Buried Via PCBs
Interlayer alignment accuracy in blind/buried via PCBs is critICal for ensuring the reliability of high-density interconnect (HDI) boards. Misalignment can lead to signal integrity degradation, impedance mismatch, and reliability risks (e.g., CAF failure). This article systematically details key technologies from material, process, equipment, and inspection perspectives.
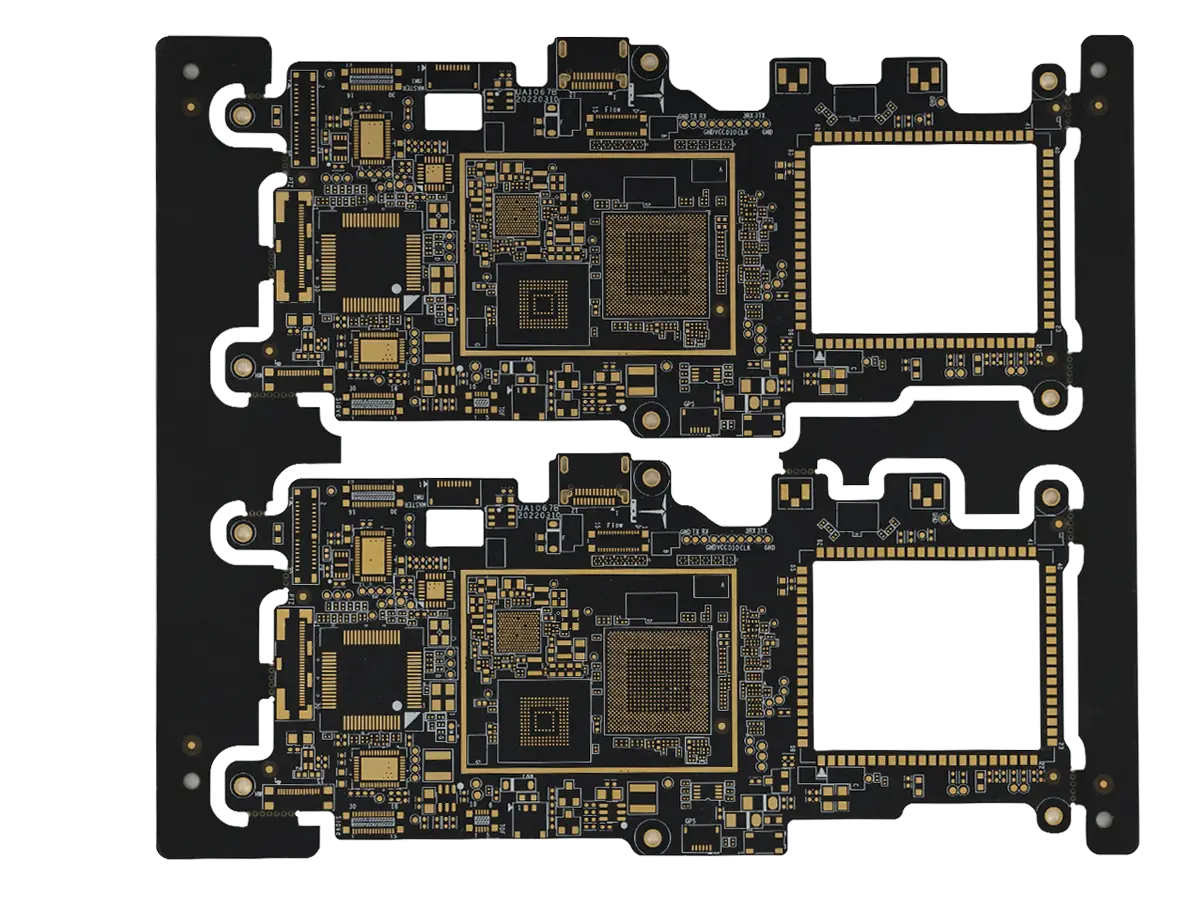
I. Material Selection and Thermal Matching
-
Low-CTE Substrates
-
High-stability materials (e.g., MEGTRON 6, IT-180A) with Tg ≥170℃ and CTE ≤14 ppm/℃ minimize thermal deformation during lamination and reflow.
-
CTE difference between core and prepreg must be ≤3 ppm/℃ to prevent interlayer stress.
-
-
Copper Foil Optimization
-
Reverse-treated foil (RTF) or hyper very low-profile foil (HVLP) with suRFace roughness Rz ≤3μm reduces dimensional fluctuations during pattern transfer.
-
II. High-Precision Pattern Alignment
-
Laser Direct Imaging (LDI)
-
Achieves ≤5μm alignment accuracy using UV lasers (355nm), eliminating film expansion errors.
-
Dynamic focus compensation (DFC) corrects local warpage-induced distortions.
-
-
Inner Layer Fiducial Design
-
≥4 global and local fiducials per layer, spaced ≥100mm, with cross/concentric structures for reliable recognition.
-
X-ray alignment systems (e.g., Orbotech XBOLT) enable sub-micron alignment of buried vias and inner traces.
-
III. Precision Drilling and Via Filling
-
Laser Drilling Optimization
-
UV picosecond lasers (10ps pulse width) create blind vias with ≤3° taper and Ra ≤5μm wall roughness.
-
Energy density gradient control (e.g., 1.2J/cm² at entrance vs. 0.8J/cm² at exit) suppresses "nail head" effects.
-
-
Via Filling Uniformity
-
Pulse reverse plating (PRP): 2ASD forward/0.5ASD reverse current achieves ≤10% dimple depth.
-
Plasma activation (O₂/N₂ mix) pre-treatment enhances copper adhesion.
-
IV. Lamination Process Control
-
Staged Pressure & Temperature Profile
-
Initial 0.5MPa pressure (prevents slippage) → 1.5MPa at Tg+20℃ → Constant-pressure curing.
-
Ramp rates ≤2℃/min (heating) and ≤3℃/min (cooling) minimize thermal stress.
-
-
Vacuum-Assisted Lamination
-
≤50Pa vacuum with 1.5mm silicone cushions ensures ≥95% pressure uniformity.
-
V. Intelligent Inspection & Feedback
-
Real-Time Warpage Monitoring
-
Laser interferometers measure post-lamination warpage (target ≤0.1% thickness), feeding data to drilling machines for positional compensation.
-
-
Interlayer Alignment Analysis
-
Cross-sectioning + metallurgical microscopy: Measures via offset (target ≤±15μm).
-
3D X-ray CT: Reconstructs via structures to analyze misalignment modes.
-
VI. Typical Process Parameters
| Process Step | Key Parameter | Target Value |
|---|---|---|
| Laser Alignment | X/Y Repeatability | ≤±3μm |
| Lamination Uniformity | Intra-board Temperature Variation | ≤±2℃ |
| Blind Via Position | vs. Design Coordinates | ≤±10μm |
| Plating Uniformity | Entrance vs. Center Thickness | ≤15% Difference |

 PCB
PCB FPC
FPC Rigid-Flex
Rigid-Flex FR-4
FR-4 HDI PCB
HDI PCB Rogers High-Frequency Board
Rogers High-Frequency Board PTFE Teflon High-Frequency Board
PTFE Teflon High-Frequency Board Aluminum
Aluminum Copper Core
Copper Core PCB Assembly
PCB Assembly LED light PCBA
LED light PCBA Memory PCBA
Memory PCBA Power Supply PCBA
Power Supply PCBA New Energey PCBA
New Energey PCBA Communication PCBA
Communication PCBA Industrial Control PCBA
Industrial Control PCBA Medical Equipment PCBA
Medical Equipment PCBA PCBA Testing Service
PCBA Testing Service Certification Application
Certification Application RoHS Certification Application
RoHS Certification Application REACH Certification Application
REACH Certification Application CE Certification Application
CE Certification Application FCC Certification Application
FCC Certification Application CQC Certification Application
CQC Certification Application UL Certification Application
UL Certification Application Transformers, Inductors
Transformers, Inductors High Frequency Transformers
High Frequency Transformers Low Frequency Transformers
Low Frequency Transformers High Power Transformers
High Power Transformers Conversion Transformers
Conversion Transformers Sealed Transformers
Sealed Transformers Ring Transformers
Ring Transformers Inductors
Inductors Wires,Cables Customized
Wires,Cables Customized Network Cables
Network Cables Power Cords
Power Cords Antenna Cables
Antenna Cables Coaxial Cables
Coaxial Cables Net Position Indicator
Net Position Indicator Solar AIS net position indicator
Solar AIS net position indicator Capacitors
Capacitors Connectors
Connectors Diodes
Diodes Embedded Processors & Controllers
Embedded Processors & Controllers Digital Signal Processors (DSP/DSC)
Digital Signal Processors (DSP/DSC) Microcontrollers (MCU/MPU/SOC)
Microcontrollers (MCU/MPU/SOC) Programmable Logic Device(CPLD/FPGA)
Programmable Logic Device(CPLD/FPGA) Communication Modules/IoT
Communication Modules/IoT Resistors
Resistors Through Hole Resistors
Through Hole Resistors Resistor Networks, Arrays
Resistor Networks, Arrays Potentiometers,Variable Resistors
Potentiometers,Variable Resistors Aluminum Case,Porcelain Tube Resistance
Aluminum Case,Porcelain Tube Resistance Current Sense Resistors,Shunt Resistors
Current Sense Resistors,Shunt Resistors Switches
Switches Transistors
Transistors Power Modules
Power Modules Isolated Power Modules
Isolated Power Modules DC-AC Module(Inverter)
DC-AC Module(Inverter) RF and Wireless
RF and Wireless