Professional Analysis of Bubble Elimination in PCB Plugging Ink Processes
Professional Analysis of Bubble Elimination in PCB Plugging Ink Processes
In PCB plugging processes, residual bubbles can lead to incomplete via filling, post-curing voids, and reliability issues such as soldering defects and CAF (Conductive AnodIC Filament) failures. Effective bubble elimination requires coordinated optimization of ink properties, equipment parameters, and process controls. Below are the critical technical considerations:
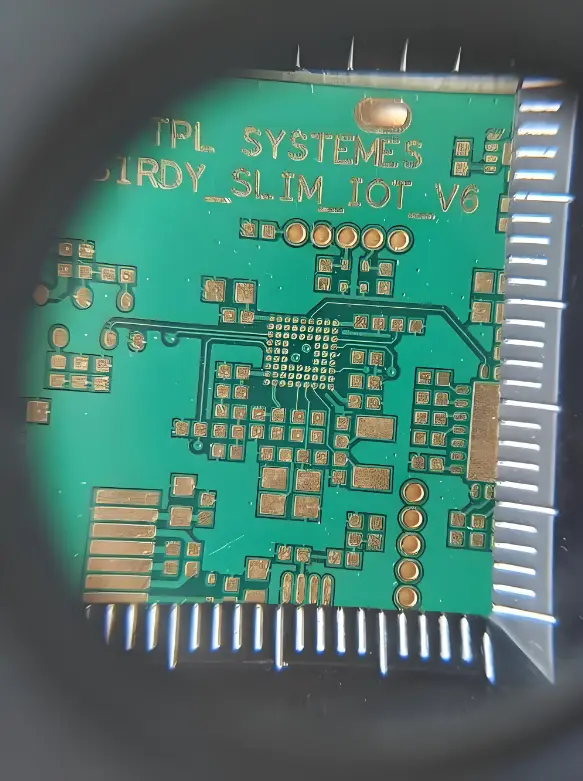
I. Bubble Formation Mechanisms
-
Physical Entrapment:
-
Air inclusion during blade SCRaping (accounts for >60% of bubbles).
-
Rough via walls (Ra>5μm) creating localized cavities.
-
-
Chemical Volatilization:
-
Solvent evaporation (e.g., butyl glycol) forming micro-bubbles before curing.
-
Resin shrinkage (>3%) generating secondary bubbles.
-
II. Ink Selection & Pretreatment
-
Low-Viscosity, High-Fluidity Inks:
-
Viscosity range: 800–1500cps (25℃, Brookfield DV2T, 20rpm).
-
Thixotropic index (TI) <1.5 for improved leveling.
-
-
Vacuum Degassing:
-
Vacuum: -0.095MPa, duration ≥30 minutes to reduce initial bubbles.
-
-
Solvent Optimization:
-
High-boiling solvents (≥40%, e.g., diethylene glycol butyl ether) delay skinning and extend bubble escape time.
-
III. Printing Parameter Optimization
1. Pressure & Speed
-
Blade Pressure: 0.2–0.4MPa; excessive pressure entraps air.
-
Print Speed: 1.5–3.0m/min; high speed causes poor leveling.
-
Squeegee Gap: 1.5–2.0×stencil thickness for uniform ink transfer.
2. Stencil Design
-
Mesh Count: 100–150T (for 0.2–0.5mm vias); higher counts reduce ink volume but risk clogging.
-
Emulsion Thickness: 15–25μm; thicker layers increase shear resistance.
-
Aperture Ratio: ≥80% to reduce flow resistance.
3. Environmental Control
-
Temperature: 23±2℃; low temps increase viscosity.
-
Humidity: 50±5%RH; high humidity slows solvent evaporation.
IV. Key Bubble Elimination Techniques
-
Stepwise Pre-Curing:
-
Stage 1: 60℃/10min for gradual bubble rise.
-
Stage 2: 80℃/20min for solvent evaporation and suRFace curing.
-
Stage 3: 150℃/30min for full curing.
-
-
Centrifugal Degassing:
-
800–1200rpm for 5–10 minutes to drive bubbles to via openings.
-
Applicable for high aspect ratio vias (>5:1).
-
-
Vacuum-Assisted Filling:
-
Vacuum: -0.08MPa with pulsed pressure (0.3MPa, 2Hz) to force ink penetration.
-
-
Ultrasonic Agitation:
-
28kHz frequency, 50–100W power to disrupt micro-bubbles via cavitation.
-
V. Quality Inspection & Defect Analysis
-
X-ray Inspection (AXI):
-
Detect bubbles >50μm (resolution ≤10μm).
-
-
Cross-Section Analysis:
-
Measure fill rate (≥95%) and via wall adhesion.
-
-
Thermal Shock Testing:
-
-55℃~125℃ cycling (5 cycles) to assess crack risks from bubble expansion.
-
VI. Case Studies & Parameters
| Process | Parameters | Bubble Residual Rate |
|---|---|---|
| Standard Printing | Blade 0.3MPa, speed 2m/min | 8%–12% |
| Centrifuge + Vacuum | 1200rpm/8min, vacuum -0.08MPa | ≤3% |
| Ultrasonic + Curing | 28kHz/80W, 60℃→80℃→150℃ | ≤1.5% |

 PCB
PCB FPC
FPC Rigid-Flex
Rigid-Flex FR-4
FR-4 HDI PCB
HDI PCB Rogers High-Frequency Board
Rogers High-Frequency Board PTFE Teflon High-Frequency Board
PTFE Teflon High-Frequency Board Aluminum
Aluminum Copper Core
Copper Core PCB Assembly
PCB Assembly LED light PCBA
LED light PCBA Memory PCBA
Memory PCBA Power Supply PCBA
Power Supply PCBA New Energey PCBA
New Energey PCBA Communication PCBA
Communication PCBA Industrial Control PCBA
Industrial Control PCBA Medical Equipment PCBA
Medical Equipment PCBA PCBA Testing Service
PCBA Testing Service Certification Application
Certification Application RoHS Certification Application
RoHS Certification Application REACH Certification Application
REACH Certification Application CE Certification Application
CE Certification Application FCC Certification Application
FCC Certification Application CQC Certification Application
CQC Certification Application UL Certification Application
UL Certification Application Transformers, Inductors
Transformers, Inductors High Frequency Transformers
High Frequency Transformers Low Frequency Transformers
Low Frequency Transformers High Power Transformers
High Power Transformers Conversion Transformers
Conversion Transformers Sealed Transformers
Sealed Transformers Ring Transformers
Ring Transformers Inductors
Inductors Wires,Cables Customized
Wires,Cables Customized Network Cables
Network Cables Power Cords
Power Cords Antenna Cables
Antenna Cables Coaxial Cables
Coaxial Cables Net Position Indicator
Net Position Indicator Solar AIS net position indicator
Solar AIS net position indicator Capacitors
Capacitors Connectors
Connectors Diodes
Diodes Embedded Processors & Controllers
Embedded Processors & Controllers Digital Signal Processors (DSP/DSC)
Digital Signal Processors (DSP/DSC) Microcontrollers (MCU/MPU/SOC)
Microcontrollers (MCU/MPU/SOC) Programmable Logic Device(CPLD/FPGA)
Programmable Logic Device(CPLD/FPGA) Communication Modules/IoT
Communication Modules/IoT Resistors
Resistors Through Hole Resistors
Through Hole Resistors Resistor Networks, Arrays
Resistor Networks, Arrays Potentiometers,Variable Resistors
Potentiometers,Variable Resistors Aluminum Case,Porcelain Tube Resistance
Aluminum Case,Porcelain Tube Resistance Current Sense Resistors,Shunt Resistors
Current Sense Resistors,Shunt Resistors Switches
Switches Transistors
Transistors Power Modules
Power Modules Isolated Power Modules
Isolated Power Modules DC-AC Module(Inverter)
DC-AC Module(Inverter) RF and Wireless
RF and Wireless