Improving Copper Plating Uniformity in High-Aspect-Ratio Vias via Atomic Layer Deposition (ALD)
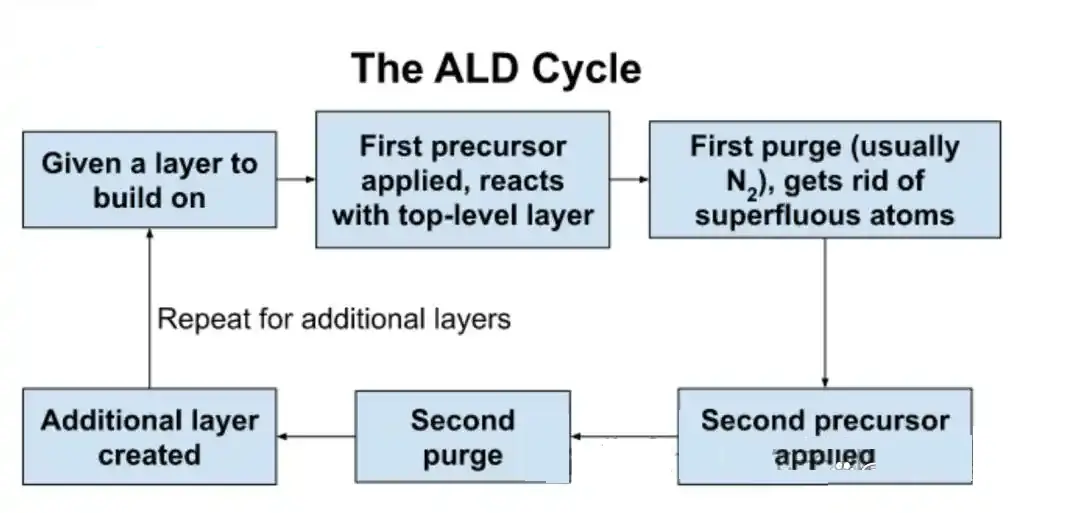
1. Principles and Advantages of ALD
Atomic Layer Deposition (ALD) employs self-limiting suRFace reactions to deposit conformal thin films (conformality >95%) through alternating precursor pulses (e.g., Cu(hfac)₂, H₂O). For high-aspect-ratio (AR>10:1) vias, ALD offers:
-
3D uniformity: Eliminates shadow effects via layer-by-layer growth, ensuring coverage at via bottoms, sidewalls, and tops;
-
Ultrathin seed layers: 2–5 nm continuous copper layers reduce activation overpotential for subsequent electroplating;
-
Interface engineering: Nanoscale barrier/seed stacks (e.g., TaN/Cu) suppress copper diffusion.
2. Key Technical Approaches
(1) Precursor and Reaction Optimization
-
Precursor selection:
-
Copper precursors: β-diketonates (e.g., Cu(acac)₂) or cyclopentadienyl compounds (e.g., CpCuPEt₃) enable efficient reactions at 150–300°C;
-
Reductants: H₂ or plasma-assisted H₂ (PE-ALD) enhance reduction efficiency, minimizing carbon residues (<5 at.%).
-
-
Pulse design:
-
Extended precursor pulse (1–5 s) and purge times (5–10 s) ensure deep via penetration;
-
Pressure gradient (0.1–1 Torr) improves precursor transport.
-
(2) Seed Layer Morphology and Electrical Tuning
-
Nano-grain control:
-
Low-temperature ALD (<200°C) produces nanocrystalline Cu (5–10 nm grains), lowering electroplating nucleation barriers;
-
Organic additives (e.g., SPS, PEG) modify surface energy for uniform plating.
-
-
Resistivity reduction:
-
In-situ plasma annealing (300°C, N₂/H₂) lowers resistivity to 2–3 μΩ·cm (near bulk Cu’s 1.7 μΩ·cm).
-
(3) Synergistic Electroplating Design
-
Pulse-reverse electroplating (PRC):
-
Optimize forward current density (1–5 mA/cm²) and pulse ratios (Ton/Toff=10:1) to suppress "dog-boning";
-
Balance deposition rates with accelerators (SPS) and inhibitors (PEG).
-
(4) Transport Dynamics Modeling
-
CFD SIMulations:
-
Model precursor diffusion/adsorption in vias to optimize pulse parameters;
-
-
Monte Carlo surface reaction models:
-
Predict ALD coverage and define critical AR limits (AR_max≈50:1).
-
3. Validation and Performance Metrics
-
Conformality tests:
-
TEM cross-sections show <±5% thickness variation in AR=20:1 vias (vs. >±30% for PVD);
-
-
Plating results:
-
ALD seeds achieve >95% bottom-up filling in AR=15:1 vias (vs. 70% for PVD);
-
-
Reliability:
-
Post-thermal cycling (-55–125°C, 1000×), resistance drift <2% with no voids/cracks.
-
4. Challenges and Solutions
-
Challenge 1: Precursor thermal instability:
-
Solution: Develop thermally stable precursors (e.g., Cu(I) amides) for >300°C processes;
-
-
Challenge 2: Precursor depletion in deep vias:
-
Solution: Synchronized pumping to maintain concentration gradients;
-
-
Challenge 3: Low ALD growth rate (<0.1 nm/cycle):
-
Solution: Spatial ALD boosts rates to >1 nm/s for high-throughput production.
-
5. Applications and Economics
-
3D TSV packaging: ALD enables void-free filling in AR=30:1 vias, increasing interconnect density 5×;
-
Advanced nodes (<5 nm): Reduces RC delay by 20% in dual damascene interconnects;
-
Cost analysis: Higher ALD tool cost (+30%) offset by yield gains (>95% vs. 80%) and material savings (-15% Cu usage).

 PCB
PCB FPC
FPC Rigid-Flex
Rigid-Flex FR-4
FR-4 HDI PCB
HDI PCB Rogers High-Frequency Board
Rogers High-Frequency Board PTFE Teflon High-Frequency Board
PTFE Teflon High-Frequency Board Aluminum
Aluminum Copper Core
Copper Core PCB Assembly
PCB Assembly LED light PCBA
LED light PCBA Memory PCBA
Memory PCBA Power Supply PCBA
Power Supply PCBA New Energey PCBA
New Energey PCBA Communication PCBA
Communication PCBA Industrial Control PCBA
Industrial Control PCBA Medical Equipment PCBA
Medical Equipment PCBA PCBA Testing Service
PCBA Testing Service Certification Application
Certification Application RoHS Certification Application
RoHS Certification Application REACH Certification Application
REACH Certification Application CE Certification Application
CE Certification Application FCC Certification Application
FCC Certification Application CQC Certification Application
CQC Certification Application UL Certification Application
UL Certification Application Transformers, Inductors
Transformers, Inductors High Frequency Transformers
High Frequency Transformers Low Frequency Transformers
Low Frequency Transformers High Power Transformers
High Power Transformers Conversion Transformers
Conversion Transformers Sealed Transformers
Sealed Transformers Ring Transformers
Ring Transformers Inductors
Inductors Wires,Cables Customized
Wires,Cables Customized Network Cables
Network Cables Power Cords
Power Cords Antenna Cables
Antenna Cables Coaxial Cables
Coaxial Cables Net Position Indicator
Net Position Indicator Solar AIS net position indicator
Solar AIS net position indicator Capacitors
Capacitors Connectors
Connectors Diodes
Diodes Embedded Processors & Controllers
Embedded Processors & Controllers Digital Signal Processors (DSP/DSC)
Digital Signal Processors (DSP/DSC) Microcontrollers (MCU/MPU/SOC)
Microcontrollers (MCU/MPU/SOC) Programmable Logic Device(CPLD/FPGA)
Programmable Logic Device(CPLD/FPGA) Communication Modules/IoT
Communication Modules/IoT Resistors
Resistors Through Hole Resistors
Through Hole Resistors Resistor Networks, Arrays
Resistor Networks, Arrays Potentiometers,Variable Resistors
Potentiometers,Variable Resistors Aluminum Case,Porcelain Tube Resistance
Aluminum Case,Porcelain Tube Resistance Current Sense Resistors,Shunt Resistors
Current Sense Resistors,Shunt Resistors Switches
Switches Transistors
Transistors Power Modules
Power Modules Isolated Power Modules
Isolated Power Modules DC-AC Module(Inverter)
DC-AC Module(Inverter) RF and Wireless
RF and Wireless