Achieving Vertical Interconnects in 2.5D/3D Packages via Through-Silicon Via (TSV) Technology
![]()
1. TSV Fundamentals and 2.5D/3D Architectures
Through-SilICon Via (TSV) enables vertical interconnects through silicon substrates, critical for chip stacking (3D) or interposer-based integration (2.5D). Key advantages include:
-
Shorter interconnects: TSVs reduce delay by >50% compared to wire bonding;
-
High bandwidth: TSV density up to 10⁴–10⁵/cm² supports HBM2e (1024-bit I/O);
-
Heterogeneous integration: Combines logic, memory, and photonic devices.
2.5D: Silicon interposers (50–100 μm thick) connect multiple chips to organic substrates (e.g., FCBGA).
3D: Direct chip stacking (e.g., DRAM-on-Logic) with TSVs for layer-to-layer connections.
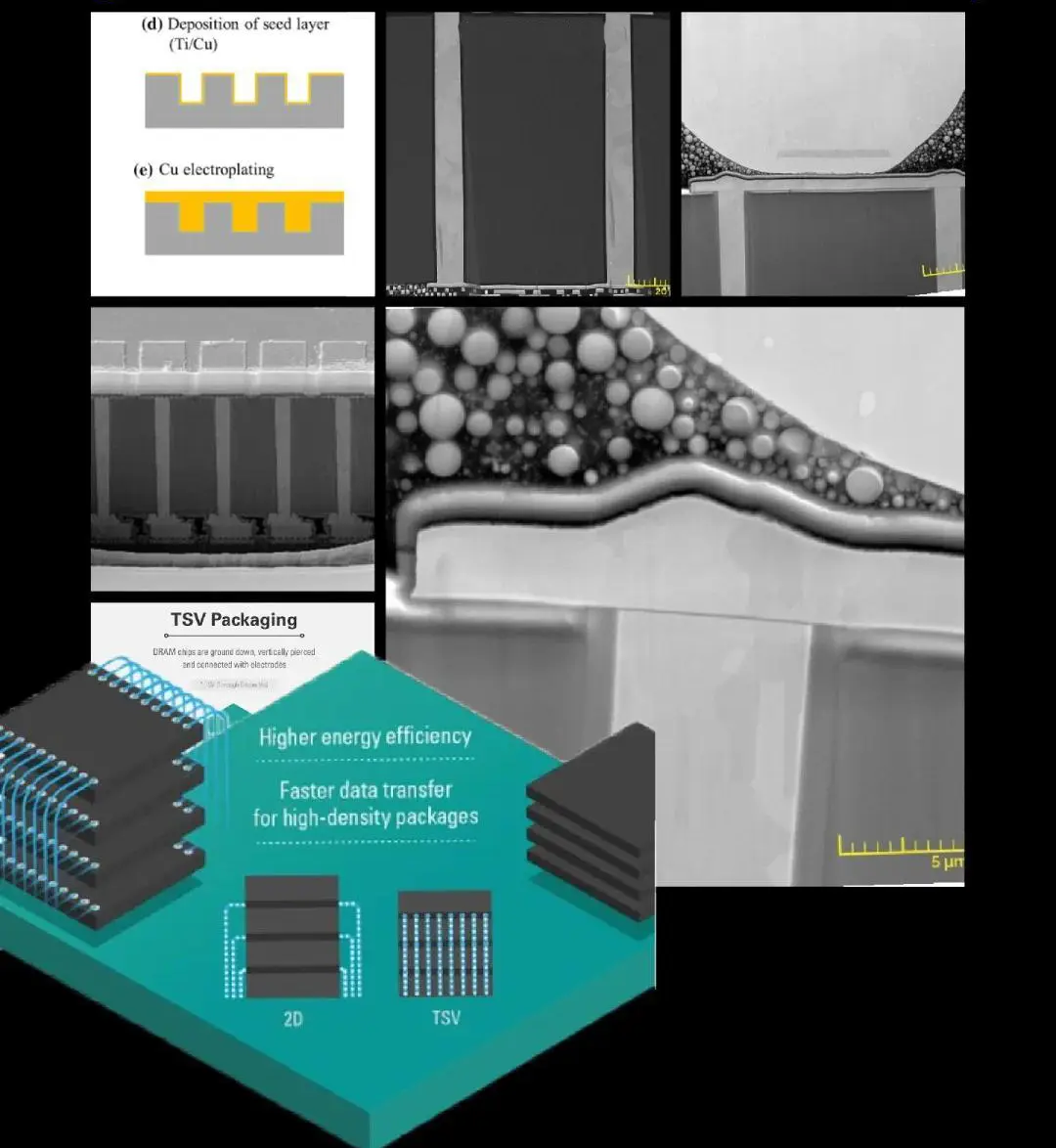
2. TSV Fabrication Process and Key Technologies
(1) Deep Reactive Ion Etching (DRIE)
-
Bosch process: Alternating SF₆ etch and C₄F₅ passivation achieves high aspect ratios (AR=10:1–20:1) with Ra <50 nm;
-
Laser drilling: For ultra-thin wafers (<50 μm) or glass vias (TGV), requiring post-CMP polishing.
(2) Insulation and Barrier Deposition
-
Insulation: PECVD SiO₂ (0.5–1 μm) or ALD Al₂O₃ (10–20 nm) for voltage isolation;
-
Barrier: PVD Ta/TaN (50 nm) to block Cu diffusion.
(3) Seed Layer and Electroplating
-
Seed layer: IMP-enhanced PVD Cu (200–500 nm) for sidewall coverage;
-
Electroplating:
-
Void-free filling via PRC with SPS/PEG additives;
-
Annealing (200–250°C) reduces resistivity to 2–3 μΩ·cm.
-
(4) Thinning and Bonding
-
Temporary bonding/thinning:
-
Grind wafers to 20–50 μm thickness using WaferBOND®;
-
XeF₂ dry etch or CMP to expose TSV Cu pillars.
-
-
Hybrid bonding:
-
Cu-Cu bonding (300–400°C, 10–50 MPa) for <10⁻⁸ Ω·cm² resistance;
-
Oxide bonding for mechanical support.
-
3. Critical Challenges and Solutions
(1) Thermal Stress Management
-
Challenge: CTE mismatch (Si: 2.6 ppm/°C vs. Cu: 17 ppm/°C) causes fatigue;
-
Solutions:
-
Annular TSVs with low-CTE polymers (e.g., BCB);
-
FEA-optimized layouts (stress <100 MPa).
-
(2) Signal/Power Integrity
-
SI: Shielded differential TSV pairs reduce crosstalk (>20 dB @10 GHz); TLM models for 50±5 Ω impedance.
-
PI: Embedded MLCCs (impedance <1 mΩ @100 MHz) and 3D power grids.
(3) Testing and Reliability
-
Electrical tests: 4PP for resistance (<50 mΩ/TSV); TDR for SI validation.
-
Reliability tests:
-
Thermal cycling (-55–125°C, 1000×) with <5% resistance drift;
-
HAST for Cu diffusion evaluation.
-
4. Advanced Trends and Applications
(1) Microbumps and Hybrid Bonding
-
Cu-Sn microbumps (5–10 μm diameter) for HBM-GPU integration;
-
Hybrid bonding (Cu/SiO₂) enables 10⁶/cm² density in 3D NAND.
(2) Photonic Integration
-
Silicon photonic interposers with TSVs and waveguides for CPO Modules (<1 dB/cm loss).
(3) Cost Control
-
Multi-project wafers (MPW) for mask sharing;
-
Wafer-level packaging (WLP) reduces per-chip steps.

 PCB
PCB FPC
FPC Rigid-Flex
Rigid-Flex FR-4
FR-4 HDI PCB
HDI PCB Rogers High-Frequency Board
Rogers High-Frequency Board PTFE Teflon High-Frequency Board
PTFE Teflon High-Frequency Board Aluminum
Aluminum Copper Core
Copper Core PCB Assembly
PCB Assembly LED light PCBA
LED light PCBA Memory PCBA
Memory PCBA Power Supply PCBA
Power Supply PCBA New Energey PCBA
New Energey PCBA Communication PCBA
Communication PCBA Industrial Control PCBA
Industrial Control PCBA Medical Equipment PCBA
Medical Equipment PCBA PCBA Testing Service
PCBA Testing Service Certification Application
Certification Application RoHS Certification Application
RoHS Certification Application REACH Certification Application
REACH Certification Application CE Certification Application
CE Certification Application FCC Certification Application
FCC Certification Application CQC Certification Application
CQC Certification Application UL Certification Application
UL Certification Application Transformers, Inductors
Transformers, Inductors High Frequency Transformers
High Frequency Transformers Low Frequency Transformers
Low Frequency Transformers High Power Transformers
High Power Transformers Conversion Transformers
Conversion Transformers Sealed Transformers
Sealed Transformers Ring Transformers
Ring Transformers Inductors
Inductors Wires,Cables Customized
Wires,Cables Customized Network Cables
Network Cables Power Cords
Power Cords Antenna Cables
Antenna Cables Coaxial Cables
Coaxial Cables Net Position Indicator
Net Position Indicator Solar AIS net position indicator
Solar AIS net position indicator Capacitors
Capacitors Connectors
Connectors Diodes
Diodes Embedded Processors & Controllers
Embedded Processors & Controllers Digital Signal Processors (DSP/DSC)
Digital Signal Processors (DSP/DSC) Microcontrollers (MCU/MPU/SOC)
Microcontrollers (MCU/MPU/SOC) Programmable Logic Device(CPLD/FPGA)
Programmable Logic Device(CPLD/FPGA) Communication Modules/IoT
Communication Modules/IoT Resistors
Resistors Through Hole Resistors
Through Hole Resistors Resistor Networks, Arrays
Resistor Networks, Arrays Potentiometers,Variable Resistors
Potentiometers,Variable Resistors Aluminum Case,Porcelain Tube Resistance
Aluminum Case,Porcelain Tube Resistance Current Sense Resistors,Shunt Resistors
Current Sense Resistors,Shunt Resistors Switches
Switches Transistors
Transistors Power Modules
Power Modules Isolated Power Modules
Isolated Power Modules DC-AC Module(Inverter)
DC-AC Module(Inverter) RF and Wireless
RF and Wireless